EV Group, ‘세미콘 코리아 2025’서 차세대 웨이퍼 템포러리 본딩 및 디본딩 솔루션 공개
경제·산업
입력 2025-02-17 16:09:55
수정 2025-02-17 16:09:55
정의준 기자
0개
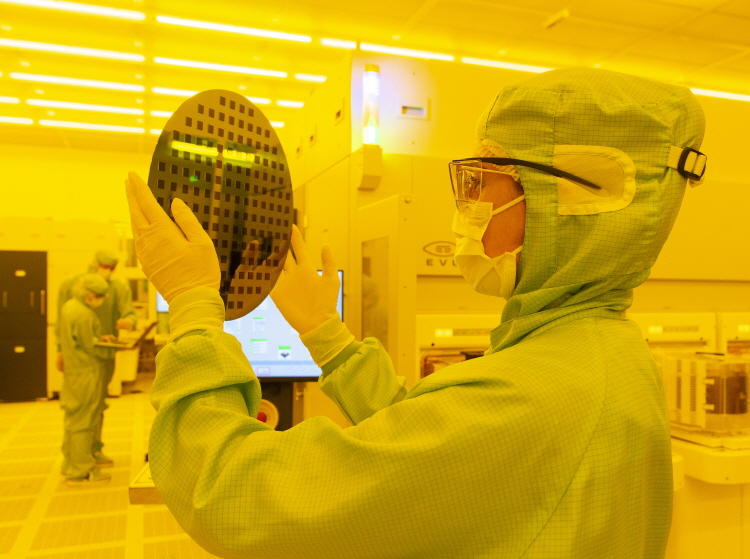
첨단 반도체 설계 및 칩 통합 방식에 대한 혁신적인 공정 솔루션과 전문성을 제공하는 EV 그룹(EV Group)은 오는 2월 19일부터 21일까지 서울 코엑스에서 개최되는 ‘세미콘 코리아 2025(SEMICON Korea 2025)’에서 IR LayerRelease 템포러리 본딩 및 디본딩(TB/DB) 솔루션을 비롯한 자사의 혁신적인 웨이퍼 본딩 및 리소그래피 기술들을 선보인다고 밝혔다.
EVG는 인공지능 가속기와 고성능 컴퓨팅(HPC)의 핵심 구성요소인 HBM(high-bandwidth memory) 및 3D DRAM의 개발 과 생산을 지원하는 TB/DB 솔루션을 포함해, 업계에서 가장 포괄적인 웨이퍼 본딩 솔루션을 제공하고 있다.
'세미콘 코리아'는 미래를 만들어 나가는 핵심 트렌드를 선보이는 세계 최고의 반도체 기술 전시회 중 하나로 올해 행사에서는 AI와 함께 첨단 패키징, 지속 가능한 반도체 제조 등이 주요 주제로 다룰 전망이다.
HBM과 3D DRAM은 높은 대역폭, 낮은 지연 시간, 저전력 특성을 최소형으로 제공하기 때문에 점점 더 증가하는 AI 학습 애플리케이션의 수요에 대응하기 위한 유망한 반도체 기술로 부상하고 있다. TB/DB는 이러한 첨단 메모리 칩 제조에 필수적인 칩 적층 공정 중에 핵심이다.
EVG의 IR LayerRelease 기술은 완전한 프런트엔드 호환성을 갖춘 레이어 분리 기술로, 실리콘을 투과하는 파장대를 갖는 적외선(IR) 레이저를 사용하는 것이 특징이다. 해당 기술은 특수하게 조성된 무기질 레이어와 함께 사용할 경우, 초박형 필름이나 레이어를 실리콘 캐리어로부터 나노미터 정밀도로 분리할 수 있으며, 업계 최고 수준의 디본딩 처리량을 제공한다.
EVG 아태지역 세일즈 디렉터인 토르스텐 마티아스 박사(Dr. Thorsten Matthias)는 “차세대 HBM 과 3D DRAM의 개발 및 양산을 가속화하는 것은 한국 반도체 업계의 최우선 과제이며, 이는 TB/DB기술의 혁신을 필요로 한다”며 “EVG의 IR LayerRelease 기술을 적용하면 더 얇은 두께의 다이를 구현함으로써 HBM을 더 높이 적층할 수 있기 때문에, 기계적 디본딩의 필요성을 없애 준다”고 전했다.
이어 “IR LayerRelease는 실리콘 캐리어 사용을 지원하면서 기계적 디본딩 공정을 대체해 현재 및 차세대 적층 메모리 공정을 모두 지원하며, 프런트엔드 호환성을 제공하므로 퓨전 및 하이브리드 본딩 공정과도 결합할 수 있어 차세대 메모리 및 비메모리 반도체에 필수적인 초박형 웨이퍼 및 필름 프로세싱에도 이상적이다”이라고 설명했다.
한편 EVG는 첨단 반도체 설계 및 칩 통합 방식을 위한 혁신적인 공정 솔루션과 전문성을 제공하는 글로벌 선도 기업으로 자세한 정보는 공식 웹사이트에서 확인할 수 있다. /정의준 기자 firstay@sedaily.com
[ⓒ 서울경제TV(www.sentv.co.kr), 무단 전재 및 재배포 금지]
관련뉴스
- 美해군, 트럼프 '황금함대' 새 전함 발주…"외국조선사도 활용"
- "AI 보안으로 클라우드 시장 잡자"…구글, 14조원 보안 파트너십
- 기아 하청노동자 '불법파견' 판단, 항소심도 유지
- 한빛-나노 발사 또 연기…이노스페이스 "기술 점검"
- 日금리인상에도 엔저…유로 대비 엔화 가치 역대 최저
- '올해 최고 청약경쟁률' K-어묵 삼진식품 상장
- 라셀턴 발톱 세럼, 소비자 평가 기반 브랜드 6관왕 성과
- 주유소 기름값 2주 연속 하락…"다음 주도 내릴 것"
- 고환율·변동성 장세 속 서학개미 투심 다소 회복
- 내년 하반기 출시 '의약 젤리', 가방 속 필수템 될까
주요뉴스
기획/취재
주간 TOP뉴스
- 1美해군, 트럼프 '황금함대' 새 전함 발주…"외국조선사도 활용"
- 2"AI 보안으로 클라우드 시장 잡자"…구글, 14조원 보안 파트너십
- 3기아 하청노동자 '불법파견' 판단, 항소심도 유지
- 4한빛-나노 발사 또 연기…이노스페이스 "기술 점검"
- 5日금리인상에도 엔저…유로 대비 엔화 가치 역대 최저
- 6'올해 최고 청약경쟁률' K-어묵 삼진식품 상장
- 7라셀턴 발톱 세럼, 소비자 평가 기반 브랜드 6관왕 성과
- 8주유소 기름값 2주 연속 하락…"다음 주도 내릴 것"
- 9영천시, 올해 청년정책 추진 성과 종합 점검. . .2025년 영천시 청년정책조정위원회 회의 개최
- 10영천시, ‘2025년 미래영천포럼’ 최종 보고회 개최











































댓글
(0)